半导体器件与物理篇5 mosfet及相关器件
认识mos二极管
MOS二极管是研究半导体表面特性最有用的器件之一。MOS二极管可作为存储电容器,并且是电荷耦合器件(CCD)的基本结构单元。
MOS二极管结构的重要参数包括:氧化层厚度d;施加于金属平板上的电压V(正偏压时V为正,负偏压时V为负);功函数(金属: q ϕ m q\phi_m qϕm;半导体: q ϕ s q\phi_s qϕs)=真空能级-费米能级;电子亲和力 q x qx qx=真空能级-半导体导带边缘;费米能级与本征费米能级的能极差 q ψ B q\psi_B qψB。
理想MOS二极管
V=0时理想p型MOS二极管的能带图:

一个理想MOS二极管应该满足的条件:
(1)零偏压时, q ϕ m s = q ϕ m − q ϕ s = 0 q\phi_{ms}=q\phi_m-q\phi_s=0 qϕms=qϕm−qϕs=0
由“能带图”可以进一步推得 p ϕ m s = 1 ϕ m − ( q x + E g w + q ψ B ) = 0 p\phi_{ms}=1\phi_m-(qx+\frac{E_g}{w}+q\psi_B)=0 pϕms=1ϕm−(qx+wEg+qψB)=0
这种无外加偏压的情况,称之为“平带情况”;
(2)在任意偏压之下,二极管中的电荷仅位于半导体之中,且与邻近氧化层表面的电荷量大小相等,但极性相反;
(3)在直流偏压下,无载流子通过氧化层,即氧化层的电阻值无穷大。
当理想MOS二极管偏压为正或负时,半导体表面可能会出现三种状况,分别是积累现象、耗尽现象、反型现象(强反型现象)。先来粗略地了解一下。
第一种:对p型半导体而言,当负电压施加于金属平板上时,SiO2-Si界面处将产生超量的空穴,接近半导体表面的能带将向上弯曲;积累现象:半导体表面向上弯曲的能带使得的能级差 E i − E F E_i-E_F Ei−EF变大,进而提升空穴的浓度,而在氧化层与半导体的界面处产生空穴堆积。
第二种,耗尽现象:当外加一小量正电压于理想MOS二极管时,靠近半导体表面的能带将向下弯曲,使 E F = E i E_F=E_i EF=Ei,形成多数载流子(空穴)耗尽。
第三种:当外加一更大的正电压时,能带向下弯曲得更严重。使得表面的本征能级E越过费米能级EF。反型现象:由于 E F − E i > 0 E_F-E_i>0 EF−Ei>0,在p型半导体表面上的电子浓度将大于 n i n_i ni,而空穴浓度将小于 n i n_i ni,即表面的电子(少数载流子)数目大于空穴(多数载流子),表面载流子呈现反型。当靠近Si0-Si界面的电子浓度等于衬底的掺杂量时,开始产生强反型。
然后让我们进一步探究这些现象。
积累现象
积累现象:半导体表面向上弯曲的能带使得的能级差 E i − E F E_i-E_F Ei−EF变大,进而提升空穴的浓度,而在氧化层与半导体的界面处产生空穴堆积。
对p型半导体而言,当负电压施加于金属平板上时, S i O 2 − S i SiO_2-Si SiO2−Si界面处将产生超量的空穴,接近半导体表面的能带将向上弯曲。
半导体表面向上弯曲的能带使得的能级差 E i − E F E_i-E_F Ei−EF变大,(已知 p p = n e x p ( E i − E F k T ) p_p=n_exp(\frac{E_i-E_F}{kT}) pp=nexp(kTEi−EF))进而提升空穴的浓度,而在氧化层与半导体的界面处产生空穴堆积,称为积累现象。

耗尽现象
耗尽现象:当外加一小量正电压于理想MOS二极管时,靠近半导体表面的能带将向下弯曲,使 E F = E i E_F=E_i EF=Ei,形成多数载流子(空穴)耗尽。
在半导体中单位面积空间电荷 Q s c = q N A W Q_{sc}=qN_AW Qsc=qNAW,其中W为表面耗尽区宽度。而在半导体表面,单位面积空间电荷浓度小,故而称为耗尽。

反型现象
当外加一更大的正电压时,能带向下弯曲得更严重。使得表面的本征能级越过费米能级。正栅极电压将在Si0,-Si的界面处吸引更多的电子。
此时虽然在对于一块p型半导体来说,电子是少子。但因为费米能级现在在本征能级之上了,而这时n型半导体的特性,所以应该使用n型半导体计算电子浓度的表达式: n p = n i e x p ( E F − E i k T ) n_p=n_iexp(\frac{E_F-E_i}{kT}) np=niexp(kTEF−Ei)
反型现象:由于 E F − E i > 0 E_F-E_i>0 EF−Ei>0,在p型半导体表面上的电子浓度将大于 n i n_i ni,而空穴浓度将小于 n i n_i ni,即表面的电子(少数载流子)数目大于空穴(多数载流子),表面载流子呈现反型。

强反型现象
当靠近 S i O 2 − S i SiO_2-Si SiO2−Si界面的电子浓度等于衬底的掺杂浓度时,开始产生**强反型*。在此之后,在半导体中额外的负电荷大部分是由电子在很窄的n型反型层( 0 ≤ x ≤ x i 0≤x≤x_i 0≤x≤xi)中产生的电荷 Q n Q_n Qn所组成。
其中 x i x_i xi为反型层的宽度, x i x_i xi典型值的范围从1nm~ 10nm,且通常远小于表面耗尽区的宽度。

当 ψ s \psi_s ψs大于 ψ B \psi_B ψB时表面即发生反型,然而,我们需要一个准则来表示强反型的起始点。超过该点表示此时反型层中的电荷数已相当显著。于是,我们设定表面电荷等于衬底杂质浓度是一个“强反型”的准则,即 n s = N A n_s=N_A ns=NA。 n s n_s ns是电子浓度, N A N_A NA电离将释放空穴。
在衬底的深处,掺杂浓度为: N A = n i e x p ( q ψ B k T ) N_A=n_iexp(\frac{q\psi_B}{kT}) NA=niexp(kTqψB)
反型时,外加偏压将先让本征费米能级降低到和 E F E_F EF一样,然后再穿过 E F E_F EF之后继续降低同等大小的电势。于是可以得到: ψ s ( i n v ) ≈ 2 ψ B = 2 k T q l n ( N A n i ) \psi_s(inv) \approx 2\psi_B=\frac{2kT}{q}ln(\frac{N_A}{n_i}) ψs(inv)≈2ψB=q2kTln(niNA)
强反型现象产生的临界电势差 ψ s ( i n v ) \psi_s(inv) ψs(inv)
表面耗尽区
p型MOS三种状态的总结: n p = { n p < n i , E i < E F , 积累 n p ≈ n i , E i = E F , 耗尽 n p > n i , E i < E F , 反型 n_p=\begin{cases} n_p<n_i ,E_i<E_F,积累\\n_p \approx n_i,E_i=E_F,耗尽\\ n_p>n_i ,E_i<E_F,反型 \end{cases} np=⎩ ⎨ ⎧np<ni,Ei<EF,积累np≈ni,Ei=EF,耗尽np>ni,Ei<EF,反型
讨论表面耗尽区,可以对很多诸如电势、浓度等变量进行分析。
假设半导体衬底内的静电势为0。在表面耗尽区,半导体表面的电子、空穴的浓度表示为电势的函数: { n s = n i e x p [ q ( ψ s − ψ B ) k T ] p s = n i e x p [ q ( ψ B − ψ s ) k T ] \begin{cases} n_s=n_iexp[\frac{q(\psi_s-\psi_B)}{kT}]\\p_s=n_iexp[\frac{q(\psi_B-\psi_s)}{kT}]\end{cases} {ns=niexp[kTq(ψs−ψB)]ps=niexp[kTq(ψB−ψs)]
费米能级与本征费米能级的能极差 ψ B \psi_B ψB;表面电势 ψ s \psi_s ψs。
对一块p型半导体而言,各区间的表面电势可以区分为:
1. ψ s < 0 \psi_s<0 ψs<0:空穴积累(能带向上弯曲);
2. ψ s = 0 \psi_s=0 ψs=0:平带情况;
3. ψ B > ψ s > 0 \psi_B>\psi_s>0 ψB>ψs>0:空穴耗尽(能带向下弯曲);
4. ψ s = ψ B \psi_s=\psi_B ψs=ψB:禁带中心,即 n s = n p = n i n_s=n_p=n_i ns=np=ni(反型与强反型的分界处);
5. ψ s > ψ B \psi_s>\psi_B ψs>ψB:反型(能带向下弯曲超过费米能级)。
用一维的泊松方程 d 2 ψ d x 2 = − ρ s ( x ) ε s \frac{d^2\psi}{dx^2}=-\frac{\rho_s(x)}{\varepsilon_s} dx2d2ψ=−εsρs(x)得到距离x的表面耗尽区的静电势分布: ψ = ψ s ( 1 − x W ) 2 \psi=\psi_s(1-\frac{x}{W})^2 ψ=ψs(1−Wx)2。
位于x处的单位体积电荷密度 ρ s ( x ) \rho_s(x) ρs(x)。
已知当半导体耗尽区宽度达到W时,半导体内的电荷为 p s = − q N A W p_s=-qN_AW ps=−qNAW,积分上述泊松方程式可得距离x的表面耗尽区静电势分布: ψ = ψ s ( 1 − x W ) 2 \psi=\psi_s(1-\frac{x}{W})^2 ψ=ψs(1−Wx)2
假设表面电荷等于衬底杂质浓度,得到表面电势为: ψ s ≈ 2 ψ B = 2 k T q l n ( N A n i ) = q N A W 2 ε s \psi_s\approx 2\psi_B=\frac{2kT}{q}ln(\frac{N_A}{n_i})=\frac{qN_AW}{2\varepsilon_s} ψs≈2ψB=q2kTln(niNA)=2εsqNAW
由 p s i = q N A W 2 2 ε s psi=\frac{qN_AW^2}{2\varepsilon_s} psi=2εsqNAW2,再代入临界电势差,可以得到表面耗尽区的最大宽度 W m W_m Wm为(表面耗尽区的最大宽度,也用 W m W_m Wm表示): W m = f r a c 2 ε s ψ s ( i n v ) q N A ≈ 2 ε ⋅ 2 ψ B q N A W_m=\sqrt{frac{2\varepsilon_s\psi_s(inv)}{qN_A}} \approx \sqrt{\frac{2\varepsilon \cdot 2\psi_B}{qN_A}} Wm=frac2εsψs(inv)qNA≈qNA2ε⋅2ψB或 W m = 2 ε s k T l n ( N A / n i ) q 2 N A W_m=2\sqrt{\frac{\varepsilon_skTln(N_A/n_i)}{q^2N_A}} Wm=2q2NAεskTln(NA/ni)
进一步推导,可以得到在半导体中单位面积空间电荷 Q s c = q N A W ≈ − 2 q ε s N A ⋅ 2 ψ B Q_{sc}=qN_AW \approx -\sqrt{2q\varepsilon_sN_A \cdot 2\psi_B} Qsc=qNAW≈−2qεsNA⋅2ψB
该小结对应例1。
理想MOS曲线
理想MOS二极管的特性有哪些:1.功函数差,为达到理想平带状况,需外加一相当于功函数差的电压;2.界面陷阱与氧化层电荷,包括界面陷阱电荷、氧化层固定电荷、氧化层陷阱电荷以及可动离子电荷。
由 V = V 0 + ψ s V=V_0+\psi_s V=V0+ψs可知,若要求电压V,需要求氧化层电压和半导体表面的电压。其中降在氧化层的电压 V 0 V_0 V0;半导体表面的电压 ψ s \psi_s ψs; 氧化层厚度 d 氧化层厚度d 氧化层厚度d。
已知 ψ = q N A W 2 ε s \psi=\frac{qN_AW}{2\varepsilon_s} ψ=2εsqNAW,因此我们还需要求氧化层电压 V 0 V_0 V0。氧化层的介电常数 ε s \varepsilon_s εs;受主杂质浓度 N A N_A NA;耗尽区宽度W
由于电压等于电场强度乘以距离 V o = E 0 d V_o=E_0d Vo=E0d,根据半导体与氧化膜之间组成了类似电容的性质,可以得到: E 0 = ∣ Q s ∣ ε o x E_0=\frac{|Q_s|}{\varepsilon_ox} E0=εox∣Qs∣
代入可以得到: V 0 = ∣ Q ∣ ε s d V_0=\frac{|Q|}{\varepsilon_s}d V0=εs∣Q∣d
又由于氧化层的电容恰好又满足: C 0 = ε o x d C_0=\frac{\varepsilon_{ox}}{d} C0=dεox,代入可得: V 0 = ∣ Q s ∣ C 0 V_0=\frac{|Q_s|}{C_0} V0=C0∣Qs∣。
综上所述,得到: V 0 = E 0 d = ∣ Q s ∣ d ε o x = ∣ Q s ∣ C 0 V_0=E_0d=\frac{|Q_s|d}{\varepsilon_ox}=\frac{|Q_s|}{C_0} V0=E0d=εox∣Qs∣d=C0∣Qs∣
氧化层中的电场 E 0 E_0 E0,半导体中每单位面积的电荷量 Q s Q_s Qs,氧化层介电常数 ε o x \varepsilon_{ox} εox,每单位面积的氧化层电容 C 0 = ε o x d C_0=\frac{\varepsilon_{ox}}{d} C0=dεox。
由突变结的性质,我们可以得到半导体中势垒电容的表达式: C j = ε s W C_j=\frac{\varepsilon_s}{W} Cj=Wεs
MOS二极管的总电容 C C C是由氧化层电容 C 0 C_0 C0与半导体中的势垒电容 C j C_j Cj相互串联而成,如图所示:

结合氧化层电容,最终得到两个电容串联的总电容为: C = C 0 C j C 0 + C j F ⋅ c m − 2 C=\frac{C_0C_j}{C_0+C_j} F\cdot cm^{-2} C=C0+CjC0CjF⋅cm−2。
组合氧化层电压和半导体表面电压,可以得到总电压的表达式: V = V 0 + ψ s = ∣ Q s ∣ C 0 + q N A W 2 ε s V=V_0+\psi_s=\frac{|Q_s|}{C_0}+\frac{qN_AW}{2\varepsilon_s} V=V0+ψs=C0∣Qs∣+2εsqNAW
氧化层电压 V 0 = ∣ Q s ∣ C 0 V_0=\frac{|Q_s|}{C_0} V0=C0∣Qs∣;表面电势 ψ s = q N A W 2 ε s \psi_s=\frac{qN_AW}{2\varepsilon_s} ψs=2εsqNAW
代入后消去W,得到总电容和氧化层电容之比: C C 0 = 1 1 + 2 ε o x 2 V q N A ε s d 2 \frac{C}{C_0}=\frac{1}{\sqrt{1+\frac{2\varepsilon_{ox}^2V}{qN_A\varepsilon_sd^2}}} C0C=1+qNAεsd22εox2V1
氧化层介电常数 ε o x \varepsilon_{ox} εox。
由上式可见,当表面开始耗尽时,电容值将会随着金属平行板上的电压增加而下降;当外加电压为负时,无耗尽区产生,将在半导体表面得到积累的空穴,因此,全部的电容值将很接近氧化层电容 ε o x / d \varepsilon_{ox}/d εox/d;反之,当强反型发生时,即使电压增加也无法增加耗尽区的宽度,表面电势达到 ψ s ( i n v ) \psi_s (inv) ψs(inv),且每单位面积的电荷为 q N A W m qN_AW_m qNAWm,可得在强反型刚发生时的金属平行板电压,我们将其定义为阈值电压 V T V_T VT: V T = ∣ Q s ∣ C 0 + ψ s ( i n v ) = q N A W m C 0 + ψ s ( i n v ) = 2 ε s q N A ⋅ ( 2 ψ B ) C 0 + 2 ψ B V_T=\frac{|Q_s|}{C_0}+\psi_s(inv)=\frac{qN_AW_m}{C_0}+\psi_s(inv)=\frac{\sqrt{2\varepsilon_sqN_A \cdot (2\psi_B)}}{C_0}+2\psi_B VT=C0∣Qs∣+ψs(inv)=C0qNAWm+ψs(inv)=C02εsqNA⋅(2ψB)+2ψB
对于一n型衬底的理想MOS二极管而言,其阈值电压将为负值。
一旦当强反型发生时,势垒电容保持最小值,即 C j = ε s / W m C_j=\varepsilon_s/W_m Cj=εs/Wm。此时的总电容为: C m i n = ε o x d + ( ε o x / ε s ) W m C_{min}=\frac{\varepsilon_{ox}}{d+(\varepsilon_{ox}/\varepsilon_s)W_m} Cmin=d+(εox/εs)Wmεox
在之前的叙述中,当金属平行板上的电压发生变化时,所有增加的电荷将出现在耗尽区的边缘。该情况只有当测量频率相当高时对才会发生。
然而,当测量频率足够低时,使得表面耗尽区内的产生-复合率与电压变化率相当或是更快时,电子浓度(少数载流子)与反型层中的电荷可以跟随交流的信号。因此导致强反型时的电容只有氧化层电容 C 0 C_0 C0。
该小结对应例2。
SiO2-Si MOS二极管
SiO2-Si系统的电特性近似于理想的MOS二极管。然而,对于广泛使用的金属电极而言,其功函数差一般不为零,而且在氧化层内部或SiO2-Si界面处存在的不同电荷,将以各种方式影响理想MOS的特性。
对于一确定功函数 q ϕ m q\phi_m qϕm的特定金属,它与功函数为 q ϕ s q\phi_s qϕs的半导体功函数差 q ϕ m s = q ( ϕ m − ϕ s ) q\phi_{ms}=q(\phi_m-\phi_s) qϕms=q(ϕm−ϕs)将会随着半导体的掺杂浓度而改变。随着电极材料与硅衬底掺杂浓度的不同,$q\phi_{ms}可能会有超过2V的变化。
普通的热平衡状态下,金属含正电荷,而半导体表面为负电荷。热平衡下的MOS二极管能带图如下:

如果将 q ϕ s q\phi_s qϕs降低,则最终可以使得中间氧化物的两侧(分别是金属和半导体)的真空能级相同。这种状态称之为平带状况。
即所有能带均保持水平的状况,称为“平带状况”
为达到理想平带状况,需外加一相当于功函数差
q ϕ m s q\phi_{ms} qϕms的电压。在此需在金属外加一负电压 V F B = ϕ m s V_{FB}=\phi_{ms} VFB=ϕms,称其为平带电压。
平带状况的能级图如下:

界面陷阱与氧化层电荷
MOS二极管还受氧化层内的电荷以及 S i O 2 − S i SiO_2-Si SiO2−Si界面陷阱的影响。
这些基本的陷阱与电荷的类型如图所示,包括有界面陷阱电荷、氧化层固定电荷、氧化层陷阱电荷以及可动离子电荷。

界面陷阱电荷
界面陷阱电荷 Q i t Q_{it} Qit是由SiO2-Si界面特性所造成,且与界面处的化学键有关。这些陷阱位于SiO2-Si界面处,而其能量则位于硅的禁带中。这些界面陷阱密度(即每单位面积与单位电子的界面陷阱数目)与晶体方向有关。在<100>方向,其界面陷阱密度约比<111>方向少一个数量级。
总结:该电荷与界面处的化学键有关。其密度与晶格方向有关。这种电荷可用低温450度的氢退火加以钝化。
氧化层固定电荷
氧化层固定电荷 Q f Q_f Qf位于距离SiO2-Si界面约3nm处。此电荷固定不动,且即使表面电势有大范围的变化仍不会有充放电现象发生。一般来说, Q f Q_f Qf为正值,且与氧化、退火的条件以及硅的晶体方向有关。一般认为当氧化停止时,一些离子化的硅留在界面处,而这些离子与表面未完全成键的硅结合(如Si-Si或Si-O键),可能导致正的界面电荷 Q f Q_f Qf产生。
总结:氧化层固定电荷与氧化、退火的条件以及硅的晶体方向有关。
氧化层陷阱电荷
氧化层陷阱电荷 Q o t Q_{ot} Qot常随着二氧化硅的缺陷而产生,这些电荷可由如X光辐射或高能量电子轰击而产生。这些陷阱分布于氧化层内部,大部分与工艺有关的#Q_{ot}可以低温退火加以去除
总结:氧化层陷阱电荷随着二氧化硅的缺陷而产生,可以用低温退火加以去除。
存在四种缺陷电荷时的平带电压计算
下面估算上述电荷对平带电压所产生的影响。
在施加负电压的一般平带状态下,电场分布的面积即为平带电压: V F B = − E 0 x 0 = Q 0 ε o x x 0 = − Q 0 x 0 C 0 d V_{FB}=-E_0x_0=\frac{Q_0}{\varepsilon_{ox}}x_0=-\frac{Q_0x_0}{C_0d} VFB=−E0x0=εoxQ0x0=−C0dQ0x0
片电荷密度 Q 0 Q_0 Q0,在氧化层的位置 x 0 x_0 x0
当片电荷越来越深入半导体,如代入 x 0 = d x_0=d x0=d,这时氧化层固定电荷将提高平带电压为: V F B = − Q 0 C 0 V_{FB}=-\frac{Q_0}{C_0} VFB=−C0Q0
倘若已知氧化层陷阱电荷的体电荷密度 ρ o t ( x ) \rho_{ot}(x) ρot(x),以及可动离子电荷的体电荷密度 ρ m ( x ) \rho_m(x) ρm(x),就可以得到 Q o t Q_{ot} Qot与 Q m Q_m Qm以及它们对平带电压的贡献。(公式略)
若功函数差的值不为0,且若界面陷阱面和可以忽略不计,由实验测得的电容-电压曲线将会从理想的理论曲线平移一个数值: V F B = ψ m s − Q f + Q m + Q o t C 0 V_{FB}=\psi_{ms}-\frac{Q_f+Q_m+Q_{ot}}{C_0} VFB=ψms−C0Qf+Qm+Qot
如果存在大量的界面陷阱电荷,这些位于界面陷阱处的电荷将随表面电势而变,C-V曲线也会随表面电势的改变而发生扭曲和偏移。
电荷耦合器件CCD
电荷耦合器件的结构:器件是由覆盖于半导体衬底的连续绝缘层(氧化层)之上,紧密排列的MOS二极管阵列所组成。
CCD的功能:CCD可以实现包含影像感测及信号处理等广泛的电子功能。
工作原理:CCD的工作原理牵涉到电荷储存及由栅极电压控制的输运行为。

图中显示对CCD施加一足够大的正偏压脉冲于所有的电极之上,以使其表面发生耗尽。一较高的偏压施加于中央的电极上,使中央的MOS结构有较深的耗尽区,并形成一电势阱。亦即由于中央电极下方较深的耗尽层而产生一个中央呈深阶状的电势分布。此时所感应生成p-Si的少数载流子(电子),则会被收集至这个电势阱中。
mosfet基本原理
MOSFET是一个四端点器件,n沟道MOSFET由一个有两个n区域(即源极与漏极)的p型半导体所组成,别名包括IGFET、MISFET、MOST。
MOSFET的结构示意图如下:

MOSFET器件中包含如下物理量:沟道长度L、掺杂深度(即结深) r j r_j rj、沟道宽度Z、氧化层厚度d;在未发生反型(即栅极的正向电压不够时)由源极流向漏极的电流,一般只有反向漏电流。
各物理量如电压电流等的下标,如G/D/S分别表示栅极、漏极、源极。
已知在MOSFET沟道内,栅极电压满足: V = 氧化层电压 V 0 + 表面电压 ψ s V=氧化层电压V_0+表面电压\psi_s V=氧化层电压V0+表面电压ψs
输出特性
线性区:沟道的作用如同电阻,漏极电流与漏极电压成正比。
夹断点:漏极电压增加到表面强反型所需的阈值电压 V T V_T VT时,在靠近y=L处的反型层厚度 x i x_i xi讲趋于0,此处称为夹断点。此时的源-漏极电压称为饱和电压 V D s a t V_{Dsat} VDsat
饱和区:漏极电压继续增大,漏极流向源极的电流保持不变,沟道长度会逐渐变短。
MOSFET基本原理的推导过程
前置的理想条件
(1)栅极结构如理想MOS二极管,即无界面陷阱、固定氧化层电荷或功函数差;
(2)仅考虑漂移电流;
(3)反型层中载流子的迁移率为固定值;
(4)沟道内杂质浓度为均匀分布;
(5)反向漏电流可忽略;
(6)沟道中由栅极电压所产生的垂直于 I D I_D ID电流方向的电场远大于由漏极电压所产生的平行于 I D I_D ID电流方向的电场.
最后一个条件称为缓变沟道近似法,通常可适用于长沟道的MOSFET中,基于此种近似法,衬底表面耗尽区中所包含的电荷量仅由栅极电压产生的电场感应所生成。
求氧化层电压
首先来看氧化层电压,它满足: V 0 = E 0 d = ∣ Q s ∣ d ε o x = ∣ Q s ∣ C 0 V_0=E_0 d=\frac{|Q_s|d}{\varepsilon_{ox}}=\frac{|Q_s|}{C_0} V0=E0d=εox∣Qs∣d=C0∣Qs∣
其中 E 0 = ∣ Q s ∣ ε o x , C 0 = ε o x d E_0=\frac{|Q_s|}{\varepsilon_{ox}} ,C_0=\frac{\varepsilon_{ox}}{d} E0=εox∣Qs∣,C0=dεox
这些公式在上一小节已经讲过了。
推导得到表面电荷量的表达式为: Q s ( y ) = − [ V G − ψ s ( y ) ] C 0 Q_s(y)=-[V_G-\psi_s(y)]C_0 Qs(y)=−[VG−ψs(y)]C0
但此时的 V G V_G VG和位于y处的表面电势 ψ s ( y ) \psi_s(y) ψs(y)均未知。
求表面电压
求单位面积电荷量
由 Q s ( y ) = − [ V G − ψ s ( y ) ] C 0 Q_s(y)=-[V_G-\psi_s(y)]C_0 Qs(y)=−[VG−ψs(y)]C0可以得到单位面积电荷量的表达式为: Q n ( y ) = 反型层中单位面积电荷量 Q s ( y ) − 表面耗尽区单位面积电荷量 Q s c ( y ) = − [ V G − ψ s ( y ) ] C 0 Q_n(y)=反型层中单位面积电荷量Q_s(y)-表面耗尽区单位面积电荷量Q_{sc}(y)=-[V_G-\psi_s(y)]C_0 Qn(y)=反型层中单位面积电荷量Qs(y)−表面耗尽区单位面积电荷量Qsc(y)=−[VG−ψs(y)]C0
表面电荷为: Q s ( y ) = − [ V G − ψ s ( y ) ] C 0 Q_s(y)=-[V_G-\psi_s(y)]C_0 Qs(y)=−[VG−ψs(y)]C0
栅极电压 V G V_G VG,表面电势 ψ s ( y ) \psi_s(y) ψs(y),栅极电容 C 0 C_0 C0
耗尽区内电荷: Q s c ( y ) = − q N A W m Q_{sc}(y)=-qN_AW_m Qsc(y)=−qNAWm
将耗尽区最大宽度 W m W_m Wm的表达式代入得到: Q s c ( y ) = − 2 ε s q N A [ 2 ψ B + V ( y ) ] Q_{sc}(y)=-\sqrt{2\varepsilon_sqN_A[2\psi_B+V(y)]} Qsc(y)=−2εsqNA[2ψB+V(y)]
将表面电荷和耗尽区内电荷代入 Q n ( y ) = Q s ( y ) − Q s c ( y ) Q_n(y)=Q_s(y)-Q_{sc}(y) Qn(y)=Qs(y)−Qsc(y),得到: Q n ( y ) = − [ V G − ψ s ( y ) ] C 0 + 2 ε s q N A [ 2 ψ B + V ( y ) ] Q_n(y)=-[V_G-\psi_s(y)]C_0+\sqrt{2\varepsilon_sqN_A[2\psi_B+V(y)]} Qn(y)=−[VG−ψs(y)]C0+2εsqNA[2ψB+V(y)]
求漏极电流
由沟道位于x处的电导率的近似值表达式,即单位长度的迁移率为: σ ( x ) = q n ( x ) μ n \sigma(x)=qn(x)\mu_n σ(x)=qn(x)μn,积分再取倒数后,得到沟道电导的表达式: g = Z L ∫ 0 x i σ ( x ) d x = Z μ n L ∫ 0 x i q n ( x ) d x g=\frac{Z}{L}\int_0^{x_i}\sigma(x)dx=\frac{Z\mu_n}{L}\int_0^{x_i}qn(x)dx g=LZ∫0xiσ(x)dx=LZμn∫0xiqn(x)dx
而且由于右半部分的积分项 ∫ 0 x i q n ( x ) d x = ∣ Q n ∣ \int_0^{x_i}qn(x)dx=|Q_n| ∫0xiqn(x)dx=∣Qn∣,得到电荷量与沟道电导的关系式: g = Z μ n L ∣ Q n ∣ g=\frac{Z\mu_n}{L}|Q_n| g=LZμn∣Qn∣
由电导与电阻互为倒数可以得到: d R = d y Z μ n ∣ Q n ( y ) ∣ dR=\frac{dy}{Z\mu_n|Qn(y)|} dR=Zμn∣Qn(y)∣dy
注意,对 Q n Q_n Qn进行微分后得到的 Q n ( y ) Q_n(y) Qn(y)
由欧姆定律得到 d V = I D ⋅ d R = d y Z μ n ∣ Q n ( y ) ∣ dV=I_D \cdot dR=\frac{dy}{Z\mu_n|Q_n(y)|} dV=ID⋅dR=Zμn∣Qn(y)∣dy
I D I_D ID为与y无关的漏电流。
将上式两边同时积分,得到: ∫ 0 V D d V = ∫ 0 L d y Z μ n ∣ Q n ( y ) ∣ \int_0^{V_D} dV=\int_0^L \frac{dy}{Z\mu_n|Q_n(y)|} ∫0VDdV=∫0LZμn∣Qn(y)∣dy
积分后进行换算,得到 I D ≈ Z L μ n C 0 { ( V G − 2 ψ B − V D 2 ) V D − 2 2 ε s q N A 3 C 0 [ ( V D + 2 ψ B ) 3 2 − ( 2 ψ B ) 3 2 ] } I_D \approx \frac{Z}{L}\mu_nC_0 \{(V_G-2\psi_B-\frac{V_D}{2})V_D-\frac{2\sqrt{2\varepsilon_sqN_A}}{3C_0}[(V_D+2\psi_B)^{\frac{3}{2}}-(2\psi_B)^{\frac{3}{2}}]\} ID≈LZμnC0{(VG−2ψB−2VD)VD−3C022εsqNA[(VD+2ψB)23−(2ψB)23]}
这个公式显然太复杂了,但因为它是后面所有简化的漏极电流的基础,所以也相当重要。
求漏极电流、阈值电压、沟道电导和跨导
线性区内
在线性区内, V D V_D VD极小(即 V D < < ( V G − V T V_D<<(V_G-V_T VD<<(VG−VT),于是我们将漏电流 I D I_D ID中所有含 V D 2 V_D^2 VD2的项全部省略,得到: I D ≈ Z L μ n C 0 ( V G − V T ) V D I_D \approx \frac{Z}{L}\mu_nC_0 (V_G-V_T)V_D ID≈LZμnC0(VG−VT)VD
其中有一个新的变量——阈值电压。阈值电压为: V T = 2 ε s q N A ⋅ ( 2 ψ B ) C 0 + 2 ψ B V_T=\frac{\sqrt{2\varepsilon_sqN_A\cdot (2\psi_B)}}{C_0}+2\psi_B VT=C02εsqNA⋅(2ψB)+2ψB
注意, I D I_D ID 对 V G V_G VG的曲线定义为转移特性曲线。
由沟道电导 g D = ∂ I D ∂ V D g_D=\frac{\partial I_D}{\partial V_D} gD=∂VD∂ID,代入可以得到: g D = Z μ n C 0 L ( V G − V T ) g_D=\frac{Z\mu_nC_0}{L}(V_G-V_T) gD=LZμnC0(VG−VT)
由跨导 g m = ∂ I D ∂ V G g_m=\frac{\partial I_D}{\partial V_G} gm=∂VG∂ID,代入可以得到: g m = Z L μ n C 0 V D g_m=\frac{Z}{L}\mu_nC_0V_D gm=LZμnC0VD
饱和区内
饱和区内需要求解的主要目标包括:饱和漏电流 I D s a t I_{Dsat} IDsat,饱和漏电压 V D s a t V_{Dsat} VDsat
其中D表示漏极(drain),sat表示饱和(satisfied)
当漏极电压增加至使得反型层中的电荷值 Q n ( y ) Q_n(y) Qn(y)在y=L处为零时,在漏极处的移动电子数目将大幅地减少,此点称为夹断点。其漏极电压与漏极电流可表示为VDsat和IDsat·。漏极电压如若继续增大,则会进入饱和区。
由于处于饱和区,因此可以得到 Q n ( y ) = Q s ( y ) − Q s c ( y ) = − [ V G − ψ s ( y ) ] C 0 − 2 ε s q N A [ 2 ψ B + V ( y ) ] = 0 Q_n(y)=Q_s(y)-Q_{sc}(y)=-[V_G-\psi_s(y)]C_0-\sqrt{2\varepsilon_sqN_A[2\psi_B+V(y)]}=0 Qn(y)=Qs(y)−Qsc(y)=−[VG−ψs(y)]C0−2εsqNA[2ψB+V(y)]=0
将上式换算后可以得到: V D s a t ≈ V G − 2 ψ B + K 2 ( 1 − 1 + 2 V G K 2 ) V_{Dsat} \approx V_G-2\psi_B+K^2(1-\sqrt{1+\frac{2V_G}{K^2}}) VDsat≈VG−2ψB+K2(1−1+K22VG)
其中 K = ε s q N A C 0 K=\frac{\sqrt{\varepsilon_sqN_A}}{C_0} K=C0εsqNA
由 I D ≈ Z L μ n C 0 { ( V G − 2 ψ B − V D 2 ) V D − 2 2 ε s q N A 3 C 0 [ ( V D + 2 ψ B ) 3 2 − ( 2 ψ B ) 3 2 ] } I_D \approx \frac{Z}{L}\mu_nC_0 \{(V_G-2\psi_B-\frac{V_D}{2})V_D-\frac{2\sqrt{2\varepsilon_sqN_A}}{3C_0}[(V_D+2\psi_B)^{\frac{3}{2}}-(2\psi_B)^{\frac{3}{2}}]\} ID≈LZμnC0{(VG−2ψB−2VD)VD−3C022εsqNA[(VD+2ψB)23−(2ψB)23]}这个关于 I D I_D ID的表达式,可以推得: I D s a t ≈ ( Z μ n C 0 2 L ) ( V G − V T ) 2 I_{Dsat}\approx (\frac{Z\mu_nC_0}{2L})(V_G-V_T)^2 IDsat≈(2LZμnC0)(VG−VT)2
由于已知 C 0 , L , V G C_0,L,V_G C0,L,VG均为常数,且对于低衬底掺杂与薄氧化层,此时的阈值电压为: V T = 2 ε s q N A ⋅ ( 2 ψ B ) C 0 + 2 ψ B V_T=\frac{\sqrt{2\varepsilon_sqN_A\cdot (2\psi_B)}}{C_0}+2\psi_B VT=C02εsqNA⋅(2ψB)+2ψB
由跨导 g m = ∂ I D ∂ V G g_m=\frac{\partial I_D}{\partial V_G} gm=∂VG∂ID,代入可以得到: g m = ∂ I D ∂ V G ∣ V D = 常数 = Z μ n ε o x L d ( V G − V T ) g_m=\frac{\partial I_D}{\partial V_G}|_{V_D=常数}=\frac{Z\mu_n\varepsilon_{ox}}{Ld}(V_G-V_T) gm=∂VG∂ID∣VD=常数=LdZμnεox(VG−VT)
MOSFET的种类
依据反型层的形式,MOSFET有四种基本的形式。假如在零栅极偏压下,沟道的电导非常低,必须在栅极外加一正电压以形成n沟道,则此器件为增强型(或称常关型)n沟道MOSFET。如果在零偏压下,已有n沟道存在,而必须外加一负电压来排除沟道中的载流子,以降低沟道电导,则此器件为耗尽型(或称常开型)n沟道MOSFET。同样也有p沟道增强型与耗尽型MOSFET。

无论是四种中的哪种类型,都有一个可以决定MOSFET何时工作的重要参数——阈值电压。理想的阈值电压为: V T = 2 ε s q N A ( 2 ψ B ) C 0 + 2 ψ B V_T=\frac{\sqrt{2\varepsilon_sqN_A(2\psi_B)}}{C_0}+2\psi_B VT=C02εsqNA(2ψB)+2ψB
然而,当考虑固定氧化层电荷以及功函数差时,将会有一平带电压偏移;除此之外,衬底偏压同样也能影响阈值电压,当一反向偏压施加于衬底与源极之间时,耗尽区将会加宽,欲达到反型所需的阈值电压必须增大,以提供更大的 Q s c Q_{sc} Qsc。可改变阈值电压的各项参数如下: V T ≈ V F B + 2 ψ B + 2 ε s q N A ( 2 ψ B + V B S ) C 0 V_T\approx V_{FB}+2\psi_B+\frac{\sqrt{2\varepsilon_sqN_A(2\psi_B+V_{BS})}}{C_0} VT≈VFB+2ψB+C02εsqNA(2ψB+VBS)
反向衬底-源级偏压 V B S V_{BS} VBS。
如何控制这个重要参数呢?方法包括:
1.一般来说,阈值电压可以通过将某种离子注入沟道区内来加以调整;
2.也可以通过改变氧化层厚度来控制 V T V_T VT,随着氧化层厚度的增加,n沟道MOSFET的阈值电压变得更大些,而p沟道MOSFET将变得更小些.对一固定的栅极电压而言,较厚的氧化层可轻易地降低电场强度。
3.选择适当的栅极材料来调整功函数差亦可用来调整阈值电压.一些如:W、TiN以及重掺杂多晶硅层等导电材料已被采用.
4.衬底偏压也可用来调整阈值电压.因衬底偏压所导致阈值电压的变化为: δ V T = 2 ε s q N A C 0 ( 2 ψ B + V B S − 2 ψ B ) \delta V_T=\frac{2\varepsilon_sqN_A}{C_0}(\sqrt{2\psi_B+V_{BS}}-\sqrt{2\psi_B}) δVT=C02εsqNA(2ψB+VBS−2ψB)
mosfet按比例缩小后发生的短沟道效应short-channel effect
较短的沟道长度可改善驱动电流( I D I_D ID~ 1 / L 1/L 1/L)以及工作时的特性,然而,由于器件尺寸的缩减,沟道边缘(如源极、极及绝缘区边缘)的扰动将变得更加重要,因此器件的特性将不再遵守长沟道近似的假设。
1.线性区中的阈值电压下跌Vth roll-off
其中 N A N_A NA为衬底的掺杂浓度, W m W_m Wm为耗尽区宽度, r j r_j rj为结深度,L为沟道长度,而 C 0 C_0 C0为每单位面积的栅极氧化层电容。
2.漏极导致势垒下降DIBL
漏极导致势垒下降DIBL:当短沟道MOSFET的漏极电压由线性区增至饱和区时,其阈值电压下跃将更严重。
3.本体穿通punch-through
本体穿通效应:总和与沟道长度相当,当漏极电压增加时,漏极结的耗尽区逐渐与源极结合并,因此大量的漏极电流可能会由漏极经本体流向源极,因此器件将会有非常高的漏电流。
按比例缩小规范scaling rule
恒定电场按比例缩小定律(CE):一个简要维持长沟道特性的方法为将所有的尺寸及电压除以比例缩小因数K(>1),如此内部电场将保持与长沟道MOSFET相似。
恒定电场定律的问题:阈值电压不可能缩的太小;源漏耗尽区宽度不可能按比例缩小;电源电压标准的改变会带来很大的不便
恒定电压等比例缩小规律(简称CV律):保持电源电压 V s V_s Vs和阈值电压 V t h V_{th} Vth不变,对其它参数进行等比例缩小。
恒定电压的问题:按CV律缩小后对电路性能的提高远不如CE律,而且采用CV律会使沟道内的电场大大增强;CV律一般只适用于沟道长度大于1um的器件,它不适用于沟道长度较短的器件。
CMOS与双极型CMOS
CMOS(complementary MOS)的结构:由成对的互补p沟道与n沟道MOSFET所组成。
CMOS的特点:具有低功率损耗以及较佳的噪声抑制能力;仅有CMOS技术被使用于ULSI(特大规模集成电路)的制造。
CMOS反相器
CMOS反相器的结构:

双极性CMOS
双极性CMOS,也称为BiCMOS:BIMOS电路包含了大部分的CMOS器件以及少部分的双极型器件,综合了双极器件高跨导、强负载驱动能力和CMOS器件高集成度、低功耗的优点,给高速、高集成度、高性能的LSI及VLSI的发展开辟了一条新的道路。
BiMOS的缺点:制作复杂、制作时间长、费用高。
mos存储器
半导体存储器可区分为挥发性(volatile)与非挥发性(nonvolatile)存储器两类。
挥发性存储器:包括动态随机存储器(DRAM)和静态随机存储器(SRAM),特点是若其电源供应关闭,将会丧失所储存的信息。
非挥发性存储器的特点:能在电源供应关闭时保留所储存的信息。
DRAM
一个DRAM的存储单元阵列如下:

DRAM的一个存储单元包含:MOSFET和一个MOS电容器(即1T/1C存储单元),结构简单且面积小。MOSFET作为一个开关,用来控制存储单元写入、更新以及读出的操作;MOS电容器则作为电容存储。
DRAM的的特点:工作是“动态”的,其信息需要周期性(一般为2ms~50ms)地重新更新。
SRAM
一个DRAM的存储单元阵列如下:

SRAM的定义与结构:SRAM是使用一双稳态的触发器(fip-flop)结构来储存逻辑状态的静态存储单元阵列,其触发器结构包含了两个相互交叉的CMOS反相器对(T1、T3;以及T2、T4)。
SRAM的特点:工作是“静态”的,不需要被更新。
习题
例1 :一 N A = 1 0 17 c m 3 N_A=10^{17}cm^3 NA=1017cm3的理想金属-二氧化硅-硅二极管,试计算表面耗尽区的最大宽度。
所用到的公式包括1.表面耗尽区的最大宽度: W m = 2 ε s ψ s ( i n v ) q N A ≈ 2 ε ⋅ 2 ψ B q N A W_m=\sqrt{\frac{2\varepsilon_s\psi_s(inv)}{qN_A}} \approx \sqrt{\frac{2\varepsilon \cdot 2\psi_B}{qN_A}} Wm=qNA2εsψs(inv)≈qNA2ε⋅2ψB或 W m = 2 ε s k T l n ( N A / n i ) q 2 N A W_m=2\sqrt{\frac{\varepsilon_skTln(N_A/n_i)}{q^2N_A}} Wm=2q2NAεskTln(NA/ni)
例2:一理想MOS二极管的 N A = 1 0 17 c m 3 N_A=10^{17}cm^3 NA=1017cm3且d=5nm,试计算其C-V曲线中的最小电容值。SiO,的相对介电常数为3.9。
所用到的公式包括1.氧化层的电容计算式 2.最大耗尽区宽度计算式 3.在阈值电压下的最小电容计算式
所用到的公式包括1.氧化层的电容计算式 C 0 = ε o x d C_0=\frac{\varepsilon_{ox}}{d} C0=dεox 2.最大耗尽区宽度计算式 3.在阈值电压下的最小电容计算式
例5:对一n型沟道n型多晶硅SiO2-Si的MOSFET,其栅极氧化层厚8nm, N A = 1 0 17 c m − 3 且 N_A=10^{17}cm^{-3}且 NA=1017cm−3且V_G=3V ,试计算其 ,试计算其 ,试计算其V_{Dsat}$
所用到的公式包括:1.电容与介电常数、宽度的关系 2.K的公式 3.用本征能级表征的表面电势 4.饱和漏极电压的表达式
例6:对一个 N A = 1 0 17 c m 3 N_A= 10^{17}cm^3 NA=1017cm3与 Q f / q = 5 × 1 0 11 c m 2 Q_f/q= 5\times 10^{11}cm^2 Qf/q=5×1011cm2的n沟道 n + n^+ n+多晶硅SiO2-Si的MOSFET而言,若栅极氧化层为5nm,试计算V值。需要多少的硼离子剂量方能使 V T V_T VT增加至0.6V?假设注入的受主在Si-SiO2界面形成一薄电荷层。
所用到的公式包括1.电容与介电常数、宽度的关系 2.用本征能级表征的表面电势 3.夹断电压的表达式 4.阈值电压的表达式(由多个电压相加得到)
所用到的公式包括1.氧化层的电容计算式 C 0 = ε o x d C_0=\frac{\varepsilon_{ox}}{d} C0=dεox 2.用本征能级表征的表面电势,即强反型现象产生的临界电势差 ψ s ( i n v ) ≈ 2 ψ B = 2 k T q l n ( N A n i ) \psi_s(inv) \approx 2\psi_B=\frac{2kT}{q}ln(\frac{N_A}{n_i}) ψs(inv)≈2ψB=q2kTln(niNA) 3.夹断电压的表达式 V F B = ψ m s − Q f + Q m + Q o t C 0 V_{FB}=\psi_{ms}-\frac{Q_f+Q_m+Q_{ot}}{C_0} VFB=ψms−C0Qf+Qm+Qot 4.阈值电压的表达式(由多个电压相加得到) V T ≈ V F B + 2 ψ B + 2 ε s q N A ( 2 ψ B + V B S ) C 0 V_T\approx V_{FB}+2\psi_B+\frac{\sqrt{2\varepsilon_sqN_A(2\psi_B+V{BS})}}{C_0} VT≈VFB+2ψB+C02εsqNA(2ψB+VBS)
例7:若例6中的栅氧化成厚度增加为500nm,其 V T V_T VT等于多少?
所用到的公式包括1.电容与介电常数、宽度的关系 2.阈值电压的表达式(由多个电压相加得到)
所用到的公式包括1.氧化层的电容计算式 C 0 = ε o x d C_0=\frac{\varepsilon_{ox}}{d} C0=dεox 2.阈值电压的表达式(由多个电压相加得到) V T ≈ V F B + 2 ψ B + 2 ε s q N A ( 2 ψ B + V B S ) C 0 V_T\approx V_{FB}+2\psi_B+\frac{\sqrt{2\varepsilon_sqN_A(2\psi_B+V{BS})}}{C_0} VT≈VFB+2ψB+C02εsqNA(2ψB+VBS)
例8:针对例6中阈值电压V-为-0.02V的MOSFET器件,假如衬底电压由0V增加至2V,试计算阈值电压的变化量。
所用到的公式包括1.因衬底偏压所导致阈值电压的变化量计算式子: Δ V T = 2 ε s q N A C 0 ( 2 ψ B + V B S − 2 ψ B ) \Delta V_T=\frac{2\varepsilon_sqN_A}{C_0}(\sqrt{2\psi_B+V_{BS}}-\sqrt{2\psi_B}) ΔVT=C02εsqNA(2ψB+VBS−2ψB)
相关文章:

半导体器件与物理篇5 mosfet及相关器件
认识mos二极管 MOS二极管是研究半导体表面特性最有用的器件之一。MOS二极管可作为存储电容器,并且是电荷耦合器件(CCD)的基本结构单元。 MOS二极管结构的重要参数包括:氧化层厚度d;施加于金属平板上的电压V(正偏压时V为正&#x…...

Hugging Face GGUF 模型可视化
Hugging Face GGUF 模型可视化 1. Finding GGUF files (检索 GGUF 模型)2. Viewer for metadata & tensors info (可视化 GGUF 模型)References 无知小儿,仙家雄霸天下,依附强者才是唯一的出路。否则天地虽大,也让你们无路可走࿰…...

PVE纵览-掌握 PVE USB 直通:让虚拟机与物理设备无缝连接
PVE纵览-掌握 PVE USB 直通:让虚拟机与物理设备无缝连接 文章目录 PVE纵览-掌握 PVE USB 直通:让虚拟机与物理设备无缝连接摘要前提条件步骤一:识别 USB 设备步骤二:编辑虚拟机配置步骤三:重启虚拟机注意事项其他配置选…...

关于系统重构实践的一些思考与总结
文章目录 一、前言二、系统重构的范式1.明确目标和背景2.兼容屏蔽对上层的影响3.设计灰度迁移方案3.1 灰度策略3.2 灰度过程设计3.2.1 case1 业务逻辑变更3.2.2 case2 底层数据变更(数据平滑迁移)3.2.3 case3 在途新旧流程兼容3.2.4 case4 接口变更3.2.5…...

DeepSeek:智能时代的AI利器及其应用前景
1.DeepSeek是什么? DeepSeek是一款基于人工智能技术的工具,旨在帮助用户高效处理和分析数据、生成内容、优化工作流程等。无论是数据分析、自然语言处理,还是自动化任务,DeepSeek都能提供强大的支持。其核心技术涵盖了机器学习、深…...
第一人称射击(FPS)游戏制作教程)
超详细UE4(虚幻4)第一人称射击(FPS)游戏制作教程
超详细UE4(虚幻4)第一人称射击(FPS)游戏制作教程 引言 在游戏开发领域,第一人称射击(FPS)游戏一直是最受欢迎的类型之一。从经典的《反恐精英》(CS)到现代的《使命召唤》(Call of Duty),FPS游戏凭借其紧张刺激的游戏体验和高度沉浸感,吸引了无数玩家。如果你是一…...

电商项目高级篇09-检索服务
电商项目高级篇09-检索服务 1、环境搭建1.1、前端静态文件准备1.2、search服务引入模版引擎1.3、index.html页面复制到templates文件夹下1.4、模仿product项目,引入名称空间1.5、动静分离,静态资源路径位置替换1.6、将1.1的静态资源放到nginx目录下1.7、…...

【网络协议大花园】应用层 http协议的使用小技巧,用好了都不用加班,效率翻两倍(下篇)
本篇会加入个人的所谓鱼式疯言 ❤️❤️❤️鱼式疯言:❤️❤️❤️此疯言非彼疯言 而是理解过并总结出来通俗易懂的大白话, 小编会尽可能的在每个概念后插入鱼式疯言,帮助大家理解的. 🤭🤭🤭可能说的不是那么严谨.但小编初心是能让更多人…...

5 前端系统开发:Vue2、Vue3框架(中):Vue前端工程化组件式开发
提示:文章写完后,目录可以自动生成,如何生成可参考右边的帮助文档 文章目录 前言五、前端工程化(使用Vue创建一个完整的企业级前端项目)1 Vue脚手架(Vue-cli)环境准备(1)…...

【Leetcode刷题记录】1456. 定长子串中元音的最大数目---定长滑动窗口即解题思路总结
1456. 定长子串中元音的最大数目 给你字符串 s 和整数 k 。请返回字符串 s 中长度为 k 的单个子字符串中可能包含的最大元音字母数。 英文中的 元音字母 为(a, e, i, o, u)。 这道题的暴力求解的思路是通过遍历字符串 s 的每一个长度为 k 的子串…...

Rust中使用ORM框架diesel报错问题
1 起初环境没有问题:在Rust开发的时候起初使用的是mingw64平台加stable-x86_64-pc-windows-gnu编译链,当使用到diesel时会报错,如下: x86_64-w64-mingw32/bin/ld.exe: cannot find -lmysql具体信息很长这是主要信息是rust找不到链…...

Java 数据库连接池:HikariCP 与 Druid 的对比
Java 数据库连接池:HikariCP 与 Druid 的对比 数据库连接池:HikariCP 1. 卓越的性能表现 HikariCP 在数据库连接池领域以其卓越的性能脱颖而出。 其字节码经过精心优化,减少了不必要的开销,使得连接获取和释放的速度极快。 在…...

04树 + 堆 + 优先队列 + 图(D1_树(D7_B+树(B+)))
目录 一、基本介绍 二、重要概念 非叶节点 叶节点 三、阶数 四、基本操作 等值查询(query) 范围查询(rangeQuery) 更新(update) 插入(insert) 删除(remove) 五、知识小结 一、基本介绍 B树是一种树数据结构,通常用于数据库和操作系统的文件系统中。 B树…...

MATLAB实现单层竞争神经网络数据分类
一.单层竞争神经网络介绍 单层竞争神经网络(Single-Layer Competitive Neural Network)是一种基于竞争学习的神经网络模型,主要用于数据分类和模式识别。其核心思想是通过神经元之间的竞争机制,使得网络能够自动学习输入数据的特…...

AITables首发:基于AI全自动推理设计数据库,国内首创,跑5分钟相当于架构师设计一周!
AITables仅运行5分钟,整个系统的表都设计好了! 随着AI大模型技术的开源普及和平民化,现如今任何一个人都有可能成为超级个体。但随着企业级业务的膨胀和业务挑战增多,我们势必要跟上AI发展的节奏,让AI帮我们设计软件。…...

Go语言中结构体字面量
结构体字面量(Struct Literal)是在 Go 语言中用于创建和初始化结构体实例的一种语法。它允许你在声明结构体变量的同时,直接为其字段赋值。结构体字面量提供了一种简洁、直观的方式来创建结构体对象。 结构体字面量有两种主要形式࿱…...

PaddleOCR 截图自动文字识别
春节假期在家无聊,撸了三个小工具:PC截图编辑/PC录屏(用于meeting录屏)/PC截屏文字识别。因为感觉这三个小工具是工作中常常需要用到的,github上也有很多开源的,不过总有点或多或少的小问题,不利于自己的使用。脚本的编…...

【Blazor学习笔记】.NET Blazor学习笔记
我是大标题 我学习Blazor的顺序是基于Blazor University,然后实际内容不完全基于它,因为它的例子还是基于.NET Core 3.1做的,距离现在很遥远了。 截至本文撰写的时间,2025年,最新的.NET是.NET9了都,可能1…...

UE求职Demo开发日志#21 背包-仓库-装备栏移动物品
1 创建一个枚举记录来源位置 UENUM(BlueprintType) enum class EMyItemLocation : uint8 {None0,Bag UMETA(DisplayName "Bag"),Armed UMETA(DisplayName "Armed"),WareHouse UMETA(DisplayName "WareHouse"), }; 2 创建一个BagPad和WarePa…...

力扣988. 从叶结点开始的最小字符串
Problem: 988. 从叶结点开始的最小字符串 文章目录 题目描述思路复杂度Code 题目描述 思路 遍历思想(利用二叉树的先序遍历) 在先序遍历的过程中,用一个变量path拼接记录下其组成的字符串,当遇到根节点时再将其反转并比较大小(字典顺序大小&…...

Vim 调用外部命令学习笔记
Vim 外部命令集成完全指南 文章目录 Vim 外部命令集成完全指南核心概念理解命令语法解析语法对比 常用外部命令详解文本排序与去重文本筛选与搜索高级 grep 搜索技巧文本替换与编辑字符处理高级文本处理编程语言处理其他实用命令 范围操作示例指定行范围处理复合命令示例 实用技…...

(十)学生端搭建
本次旨在将之前的已完成的部分功能进行拼装到学生端,同时完善学生端的构建。本次工作主要包括: 1.学生端整体界面布局 2.模拟考场与部分个人画像流程的串联 3.整体学生端逻辑 一、学生端 在主界面可以选择自己的用户角色 选择学生则进入学生登录界面…...

.Net框架,除了EF还有很多很多......
文章目录 1. 引言2. Dapper2.1 概述与设计原理2.2 核心功能与代码示例基本查询多映射查询存储过程调用 2.3 性能优化原理2.4 适用场景 3. NHibernate3.1 概述与架构设计3.2 映射配置示例Fluent映射XML映射 3.3 查询示例HQL查询Criteria APILINQ提供程序 3.4 高级特性3.5 适用场…...

线程与协程
1. 线程与协程 1.1. “函数调用级别”的切换、上下文切换 1. 函数调用级别的切换 “函数调用级别的切换”是指:像函数调用/返回一样轻量地完成任务切换。 举例说明: 当你在程序中写一个函数调用: funcA() 然后 funcA 执行完后返回&…...
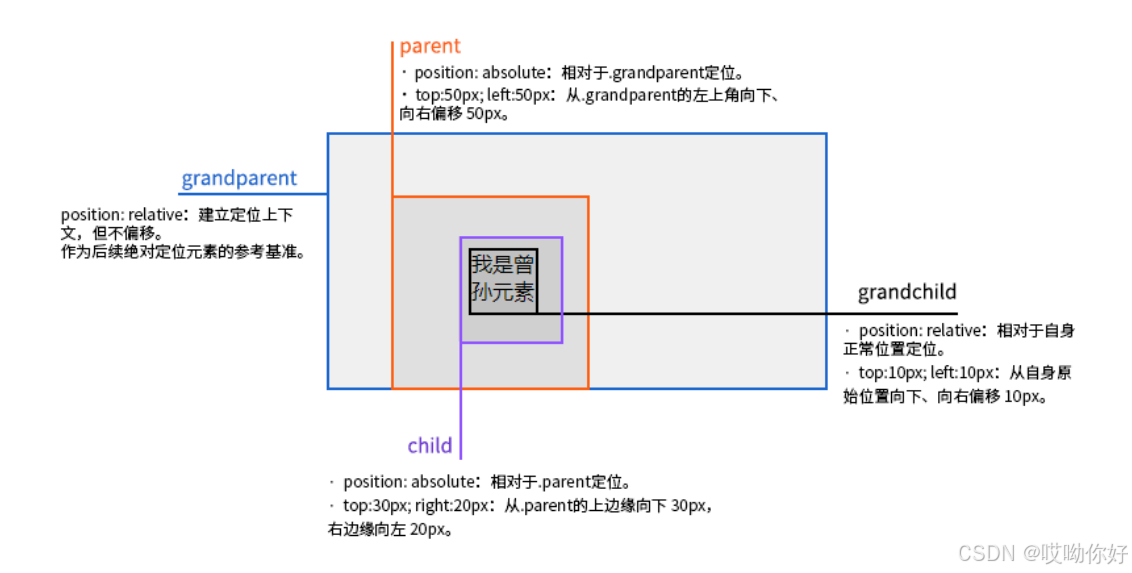
【CSS position 属性】static、relative、fixed、absolute 、sticky详细介绍,多层嵌套定位示例
文章目录 ★ position 的五种类型及基本用法 ★ 一、position 属性概述 二、position 的五种类型详解(初学者版) 1. static(默认值) 2. relative(相对定位) 3. absolute(绝对定位) 4. fixed(固定定位) 5. sticky(粘性定位) 三、定位元素的层级关系(z-i…...

今日科技热点速览
🔥 今日科技热点速览 🎮 任天堂Switch 2 正式发售 任天堂新一代游戏主机 Switch 2 今日正式上线发售,主打更强图形性能与沉浸式体验,支持多模态交互,受到全球玩家热捧 。 🤖 人工智能持续突破 DeepSeek-R1&…...

OPENCV形态学基础之二腐蚀
一.腐蚀的原理 (图1) 数学表达式:dst(x,y) erode(src(x,y)) min(x,y)src(xx,yy) 腐蚀也是图像形态学的基本功能之一,腐蚀跟膨胀属于反向操作,膨胀是把图像图像变大,而腐蚀就是把图像变小。腐蚀后的图像变小变暗淡。 腐蚀…...

AI病理诊断七剑下天山,医疗未来触手可及
一、病理诊断困局:刀尖上的医学艺术 1.1 金标准背后的隐痛 病理诊断被誉为"诊断的诊断",医生需通过显微镜观察组织切片,在细胞迷宫中捕捉癌变信号。某省病理质控报告显示,基层医院误诊率达12%-15%,专家会诊…...

在鸿蒙HarmonyOS 5中使用DevEco Studio实现企业微信功能
1. 开发环境准备 安装DevEco Studio 3.1: 从华为开发者官网下载最新版DevEco Studio安装HarmonyOS 5.0 SDK 项目配置: // module.json5 {"module": {"requestPermissions": [{"name": "ohos.permis…...

MinIO Docker 部署:仅开放一个端口
MinIO Docker 部署:仅开放一个端口 在实际的服务器部署中,出于安全和管理的考虑,我们可能只能开放一个端口。MinIO 是一个高性能的对象存储服务,支持 Docker 部署,但默认情况下它需要两个端口:一个是 API 端口(用于存储和访问数据),另一个是控制台端口(用于管理界面…...
